在半导体湿法制程中,DHF、BHF 和 BOE 都是以氢氟酸(HF)为核心基础,专门用来刻蚀或清洗二氧化硅(SiO2)的化学品。
它们的核心化学反应完全一样:SiO2 + 6HF ---》H2SiF6 + 2H2O它们的本质区别在于溶液的成分配比以及由此带来的刻蚀速率稳定性。
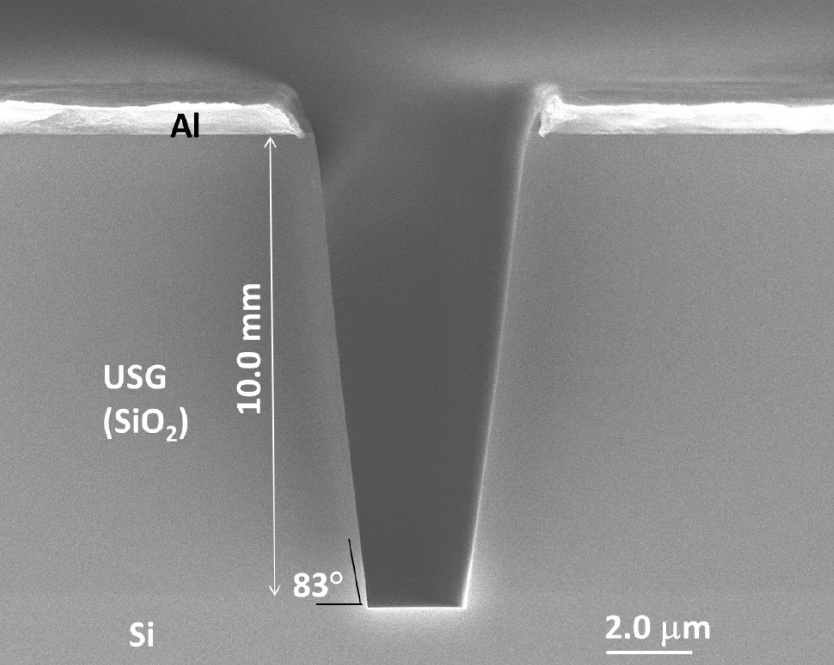
DHF (Dilute Hydrofluoric Acid) —— 稀氢氟酸
成分:纯氢氟酸(HF) + 去离子水。通常按照体积比 1:50、1:100 甚至更稀的比例配制。
特点:速率不稳定。在纯 DHF 中,随着刻蚀的进行,HF 被迅速消耗,溶液中的 F- 离子浓度和 pH 值会发生剧烈变化。这导致刻蚀速率会随着时间的推移而迅速下降,很难做到大批量、长时间的精确刻蚀控制。
主要用途:去除硅片表面的自然氧化层(Native Oxide),通常只需要几秒钟。
清洗工艺(如 RCA 清洗中的最后一步,或 CMP 研磨后的清洗),剥离表面极其微薄的氧化物以去除附着的颗粒。
BHF (Buffered Hydrofluoric Acid) —— 缓冲氢氟酸
成分:氢氟酸(HF) + 氟化铵(NH4F) + 去离子水。
特点:速率极度稳定。这里的氟化铵充当了缓冲剂(Buffer)的作用。它不仅把溶液的 pH 值稳定在弱酸性(约 3 - 4),更重要的是,当 HF 在刻蚀中被消耗时,NH4F 会不断电离补充 F 离子,维持体系内活性物质的浓度平衡。
主要用途:厚氧化层(Thermal Oxide, TEOS 等)的图形化刻蚀。需要长时间浸泡且对刻蚀深度要求极度精确的工艺。
BOE (Buffered Oxide Etch) —— 缓冲氧化物刻蚀液
真相:BOE 和 BHF 在晶圆厂里通常指的是同一种东西。区别在于命名角度:BHF 是从化学成分的角度命名的(缓冲氢氟酸)。BOE 是从工艺用途的角度命名的(缓冲氧化物刻蚀)。
常见的配比:在产线上,BOE 通常有固定的行业标准配比,最经典的是 6:1 BOE(即 6 份 40% 的 NH4F 溶液与 1 份 49% 的 HF 溶液混合)。此外还有 10:1、20:1 等,不同比例对应不同的刻蚀速率。